
芯片制造行業中的臭氧用途
二十多年來,半導體行業研究人員已經研究了將臭氧用于晶片清潔和抗蝕劑剝離應用的情況。為了降低化學藥品的消耗和處置成本以及提高清潔效率,使用臭氧以替代傳統的使用堿性(SC-1)和酸性(SC-2)氫的硫酸-過氧化物和RCA清潔過氧化物混合物。
在芯片制造過程中,臭氧主要用于清潔晶圓;消除有機物,金屬和顆粒;去除光刻膠;對去離子水設施進行消毒。用臭氧清潔總是涉及氧化,工藝差異取決于清潔步驟的主要目的。
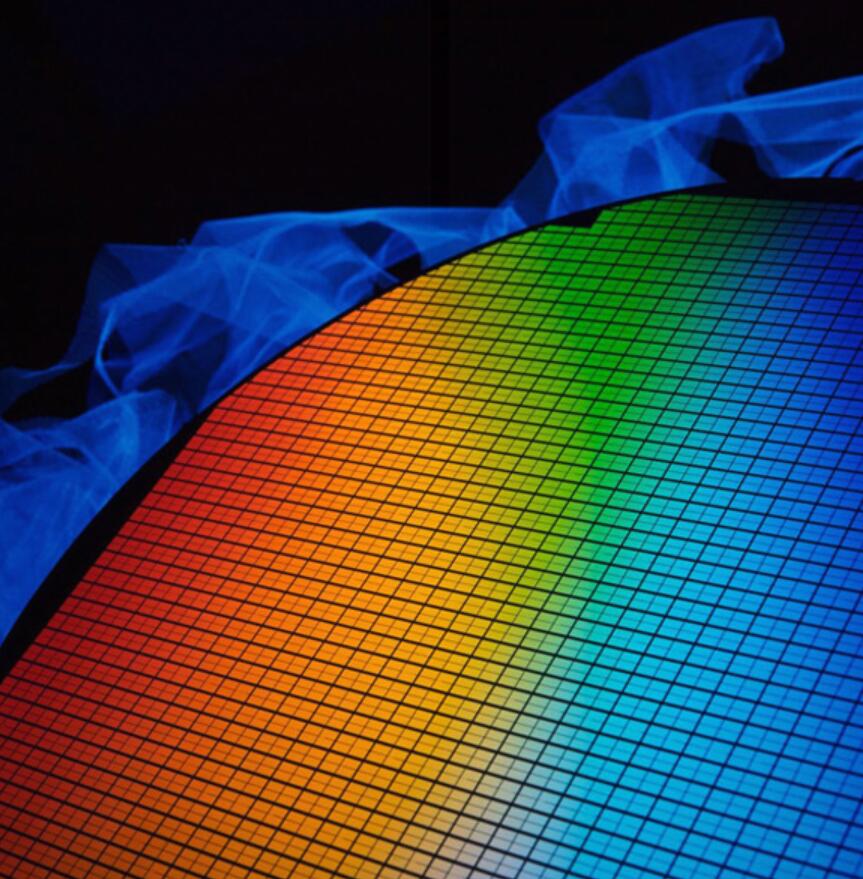
去除有機物
關于臭氧去除有機物的能力,可以從臭氧用在飲用水和廢水的處理研究中獲得。臭氧處理過的去離子水(DIO3)具有很高的氧化潛能,可以降低有機污染物的含量。它的去除效率取決于有機物種類,臭氧濃度和反應方式。
溶于超純水中的臭氧在自分解過程中會產生OH活性自由基。臭氧直接分解有機物時,活性自由基則間接分解有機物。不同的反應途徑導致不同的氧化產物。直接的臭氧反應途徑是選擇性的,反應速率常數通常較慢。間接OH反應快速且非選擇性,但必須通過引發劑(例如高pH,過氧化氫或UV輻射)激活。盡管期望快速反應,但是應避免僅由自由基進行的反應。在許多情況下,活性物種必須直接作用于表面,因為離表面太遠生成的物種會失活和丟失。
去除金屬和顆粒
單獨的DIO3不能有效去除沉積在硅表面的鐵,鎳,鋁,鎂和鈣等金屬,例如金屬氫氧化物或金屬氧化物。取決于它們的性質,金屬可以結合到氧化物層中或駐留在Si-SiO 2 界面處。可以用充當離子交換劑的酸除去它們,或者可以使用氫氟酸(HF)溶解氧化物,從而除去金屬。
如果DIO3 具有有機性質,則僅DIO3可能足以去除其附著的顆粒。然而,通常通過用稀氫氟酸(dHF)蝕刻顆粒下方的氧化物并避免顆粒再沉積來去除二氧化硅上的顆粒。如果粒子的大部分未被dHF溶解,則O3作為氧化劑可產生可被HF蝕刻的新層。對于硅顆粒和硅表面而言確實如此。
在硅上形成氧化物層是自限過程。在室溫下,硅表面的氧化會形成一個氧化層,其厚度可達到約1 nm。薄氧化物層的質量取決于其他參數,例如濕度。在涉及噴霧和浸沒工具的測試中,初始氧化物生長速率是臭氧濃度的函數。在浸沒工具中, 很終氧化物厚度取決于初始臭氧濃度和pH值,表明反應受限。但是,由于在這些測試中使用了靜態系統,因此臭氧的衰減和消耗可能會影響結果。
關于將臭氧與HF和/或鹽酸(HCl)或兩者結合的清潔工藝的一些研究已經發表。在這些研究中,將化學藥品依次或以混合物的形式應用在噴霧,浸浴或單晶片工藝中。
重復使用臭氧水和稀氟化氫(SCROD)方法進行單晶片旋轉清洗,將稀的dHF和DIO3交替分配在旋轉的晶片上。9根據所需的表面 很終條件,該過程以dHF /漂洗或DIO3 /漂洗結束,然后在氮氣中旋轉干燥。一分鐘的三周期過程可以除去87%的Al 2 O3顆粒,97%的Si 3 N 4顆粒和99.5%的聚苯乙烯膠乳顆粒。與采用dHF和DIO3的方法相反 同時,重復的SCROD清潔不會增加表面粗糙度。
光刻膠去除
用于去除光刻膠的傳統濕化學工藝依賴于濃硫酸與過氧化氫(SPM)或臭氧(SOM)的結合。使用溶解在去離子水中的臭氧的另一種方法可帶來環境效益并降低成本。
DIO3中的光致抗蝕劑剝離速率隨臭氧濃度或溫度(在恒定臭氧濃度下)的增加而增加。不幸的是,隨著溫度的升高,水中的飽和臭氧濃度會降低,而臭氧衰減率會增加。必須仔細優化臭氧的輸送過程,以達到 很大的光刻膠去除率。
一些文獻報道了在抗蝕劑剝離工藝中使用臭氧的幾種嘗試。例如,在使用時將臭氧與去離子水混合以達到較高的臭氧濃度,并且添加了清除劑以防止臭氧衰減。10-13 已發現剝離速率受溶解的臭氧從散裝液體進入晶片表面邊界層的傳質速率的影響。可以通過采用超音速攪拌或通過減小邊界層的厚度(例如,通過提高旋轉工具中的晶片旋轉速度)來減少擴散限制。為了克服邊界層屏障的影響,研究人員在高溫下將臭氧氣體與水蒸氣混合。12 清除劑的添加和溫度的升高提高了剝離速度。然而,取決于抗蝕劑的類型和所使用的曝光后處理,使用濕法清潔工藝去除光致抗蝕劑仍然是一個挑戰。
消毒
大約一個世紀前,將臭氧引入水處理系統的目的是對微生物污染的水進行消毒。在半導體世界中,臭氧用于消毒水凈化系統。但是,用于凈化飲用水的化學藥品(如氯或二氧化氯)在IC工業中是不可接受的。臭氧的一個優點是它會分解回氧氣。但是,在封閉的水凈化系統中,氧氣濃度會累積到高于《國際半導體技術路線圖》中指定的水平。
水消毒所需的臭氧濃度遠低于晶片清潔所需的臭氧濃度。一個關鍵參數是游離消毒劑濃度c乘以可用接觸時間 t(CT值)。 CT值1.6-2.0 mg / L / min被認為足以有效消毒。
結論
隨著晶圓結構的復雜性增加,晶圓濕法清潔工藝將繼續在半導體制造中發揮重要作用。可靠的臭氧發生系統的發展使臭氧成為傳統濕法清潔和光刻膠去除方法的有吸引力的替代方法。臭氧/水清洗工藝比RCA清洗技術便宜,而且對環境無害。臭氧不再僅僅對半導體應用具有科學意義;它可以在晶圓和IC制造過程中提供實際的好處。
標簽:臭氧(76)芯片制造(1)清潔晶圓(1)
相關文章:













